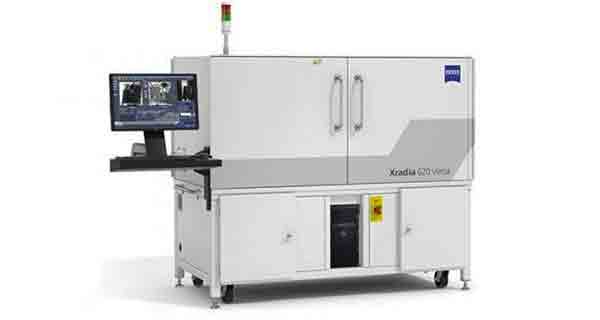
ZEISS представил две передовые модели рентгеновского микроскопа семейства ZEISS Xradia Versa: ZEISS Xradia 610 и 620 Versa. Основываясь на лучшем в отрасли разрешении и контрастности, ZEISS Xradia 610 и 620 Versa расширяют границы вашего неразрушающего изображения субмикронного масштаба.
В то время как традиционная томография основывается на одноступенчатом геометрическом увеличении, Xradia Versa предлагает комбинацию уникальной оптики с двухступенчатым увеличением и высокопоточного рентгеновского источника для получения более быстрых изображений с разрешением субмикронного масштаба. Архитектура «Разрешение на расстоянии» (RaaD) обеспечивает трехмерное изображение с высоким разрешением для более крупных и плотных объектов, включая неповрежденные компоненты и устройства. Дополнительное расширение для плоских панелей (FPX) позволяет быстро сканировать очень большие образцы (до 25 кг), обеспечивая навигацию к интересующим внутренним областям.
ZEISS Xradia 600-серии Versa представляет революционную технологию рентгеновского источника высокой мощности (25 Вт), которая может обеспечить значительно более высокий поток рентгеновского излучения по сравнению с его предшественниками. Новый источник расширяет границы производительности благодаря улучшенному управлению температурой, увеличению потока и пропускной способности при сохранении производительности разрешения. Новая система управления исходным кодом повышает скорость отклика источника, обеспечивая более быструю настройку сканирования, что облегчает и повышает удобство работы пользователя.
Что предлагает более высокий рентгеновский поток:
-
-
- Ускоренная томография
- Больше пробных прогонов
- Больше областей интереса
- Более высокое отношение контрастности к шуму
- Более сильные дифракционные картины
- Включение длинных / мультисканирующих рабочих процессов
-
Достоинства
-
-
- Неразрушающая субмикронная микроскопия интактных образцов
- Более высокий поток и быстрое сканирование без ущерба для разрешения
- Истинное пространственное разрешение 500 нм с минимально достижимым размером вокселя 40 нм
- Высокое разрешение в широком диапазоне типов образцов, размеров и рабочих расстояний
- Визуализация in situ для неразрушающего определения характеристик микроструктур в контролируемых средах и во времени
- Возможность обновления и расширения с будущими инновациями и разработками
-
Источник: www.zeiss.com


